12吋晶圓再生服務


- 產能:每月22萬片
- 銅製程與鋁製程生產線





Vertabake是最先進且具有成本效益的晶圓批次烘烤解決方案,一次烘烤可以處理1批貨(25 片),可選擇對批次晶圓進行垂直或水平烘烤。應用於先進封裝的預成型烘烤及預底部填充烘烤。
Vertabake系列的先進烘烤設備可應用在先進半導體封裝領域,其應用製程為:

辛耘憑藉在半導體領域專業的自製機台研發能力,開發出Pyxis系列的剝離清洗設備,可為半導體晶圓薄化製程及半導體先進封裝製程中剝離後的玻璃及晶圓清洗提供解決方案。
Pyxis系列的剝離清洗設備可應用在:
其應用製程如下:

辛耘與國際大廠3M合作,開發出Pyxis系列的剝離設備,包含框架剝離設備(Frame Debonding Equipment )和Taiko剝離設備(Taiko Debonding Equipment),可為晶圓薄化(Wafer Thinning及BGBM (Backside Grinding & Backside Metallization)的玻璃剝離製程提供解決方案。
Pyxis系列的剝離設備可應用在:
其應用製程為:

Polar系列是單晶圓(Wafer)表面處理系統,應用了FEoL研究成果和積累的相關領域專業經驗。該系統為先進的清洗(Clean)和蝕刻(Etching)製程提供了卓越的性能和可擴展性,具有高吞吐量和更小的佔地面積。憑藉業界公認的高可靠性和生產力,不斷發展技術以滿足客戶要求並創造全新的高級清潔解決方案,成為領先的國產單晶圓濕製程處理設備。
Polar系列單晶圓濕製程設備可應用在以下領域:
其應用製程如下:

隨著半導體封裝朝面板級封裝 (Panel-level Packaging )演進,辛耘憑藉在半導體領域專業的單片濕製程自製機台經驗,因應市場的需求,成功研發出Polar-Panel單片面板級濕製程機台,應用在面板級封裝相關濕製程。
面板級封裝機台系列的單片面板級濕製程設備 ,可應用在面板級先進封裝 (Panel-level Advanced Packaging ),包含:
其應用製程如下:

隨著半導體封裝朝面板級封裝 (Panel-level packaging )演進,辛耘憑藉在半導體領域專業的單片解離層塗佈自製機台經驗,因應市場的需求,成功研發出Pyxis-Panel單片面板級解離層塗佈設備,應用在面板級封裝解離層塗佈製程。
面板級封裝機台系列的單片面板級解離層塗佈設備,可應用在面板級先進封裝 (Panel-level Advanced Packaging ),包含:
其主要應用製程為:

WS (Wet Station)系列是最先進的具有成本效益的晶圓系統解決方案,可在一個批次中最多處理 50 片晶圓,並有多個槽體適用於各種化學品。支持薄膜前清潔、蝕刻、蝕刻後清潔和光阻剝離等傳統濕法製程。全新開發的設備功能,可實現更小佔地面積、卓越生產力、極佳清潔效果的批次設備。
WS系列批次式晶圓濕製程設備可應用在以下領域:
其應用製程如下:

隨著半導體封裝朝面板級封裝 (Panel-level Packaging )演進,辛耘憑藉在半導體領域專業的批次濕製程自製機台經驗,因應市場的需求,成功研發出面板級批次濕製程機台,應用在面板級封裝相關製程。WSE-Panel是最先進且具有成本效益的面板級批次濕製程系統解決方案,可在一個批次中處理多片面板,並有多個槽體適用於各種化學品。
面板級封裝機台系列的批次面板級濕製程設備,可應用在面板級先進封裝 (Panel-level Advanced Packaging ),包含:
其應用製程如下:

辛耘與國際大廠3M,合作開發出Pyxis系列的暫時性貼合設備,可為晶圓薄化(Wafer Thinning)及BGBM (Backside Grinding & Backside Metallization)的玻璃貼合製程提供解決方案。另辛耘憑藉在半導體領域專業的自製機台研發能力,開發出暫時性貼合設備可應用在半導體先進封裝製程。
Pyxis系列的暫時性貼合設備可應用在:
其應用製程為:
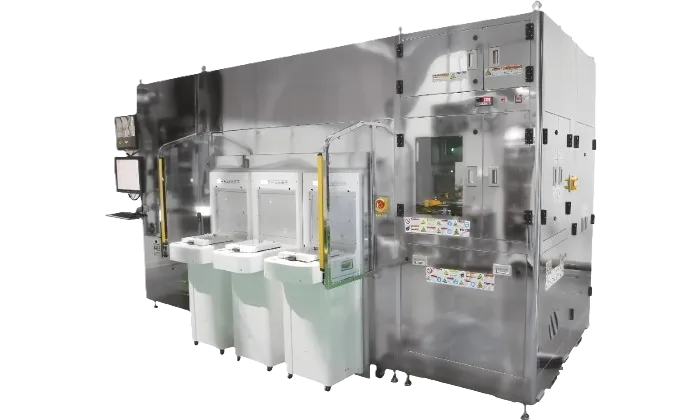
辛耘與國際大廠3M合作,開發出Pyxis系列的玻璃解離層塗層設備,可為晶圓薄化(Wafer Thinning)、BGBM (Backside Grinding & Backside Metallization)及半導體先進封裝製程 中的玻璃解離層塗佈提供解決方案。
Pyxis系列的玻璃解離層塗層設備可應用在:
其應用製程為: