
Napra has successfully developed and manufactured the world's first homogeneous fine alloy particles featuring a nano-composite structure.
These patented fine alloy particles deliver breakthrough performance, offering innovative solutions for the manufacturing of semiconductor devices and next-generation precision electronic components.
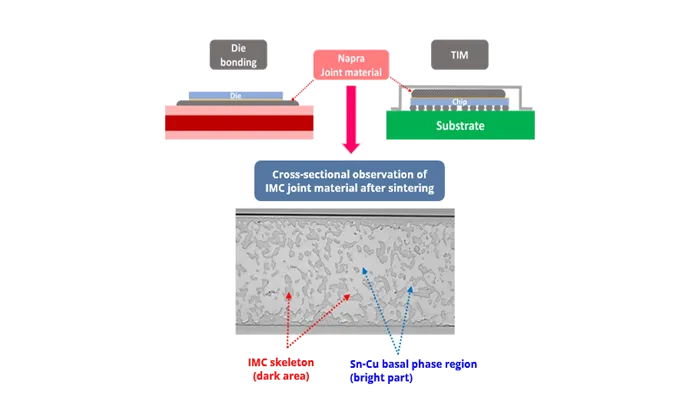
IMC joint material
Napra’s advanced joint materials, available in IMC sheet and paste forms, are based on a Cu-Sn-Ni metal alloy system. These materials are designed for die and substrate attachment and can also serve as thermal interface materials (TIM) or die bonding solutions.
Key Features
- Cost-effective alternative to Ag and Cu sintering technologies
- Enables high-temperature operation with low-temperature processing, ideal for high-power devices
- Excellent reliability performance, including TCT, HTSL, and die shear strength
- Suitable for large-area joints with minimal void formation
- Helps prevent voids, delamination, and cracking during operation





