PacTech

PacTech是一家以技術為重點的公司,專門從事先進的封裝設備製造和晶圓級封裝服務。
自1995年成立以來,PacTech團隊一直不懈地致力於為下一代應用開發新的領先技術。眾所周知,PacTech對客製和獨特之應用具有高度的符合性,PacTech研發團隊努力解決行業所面臨的各種高階封裝挑戰,並在有限成本及有限開發時程下,提出更具競爭力的解決方案。
PacTech總部位於德國諾恩,而在美國加州的聖克拉拉和馬來西亞的檳城有兩個營運據點及生產工廠。
SB2系列-雷射輔助精密焊接與植球設備
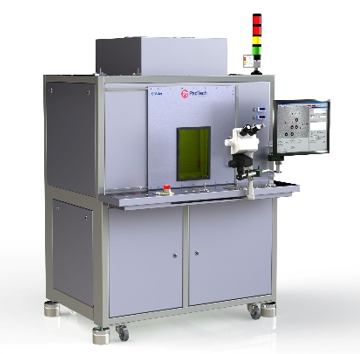
SB2系列設備是利用氮氣推動系統及雷射輔助加熱系統,將設備錫球槽中之錫球利用氮氣推動單顆噴出,並同時利用雷射回焊使錫球熔融,噴射至待植金屬墊(UBM)上,並完成接著,每秒可植高達6~8顆球。
此過程中無需使用助焊劑(Fluxless),故植球後無需清洗,且適用於不同熔點之各種錫球,包括無鉛锡球、高鉛锡球及金錫合金锡球等,其球徑介於40 - 760μm,其中包括超密間距之應用。
利用雷射產生之局部能量及極短脈衝特性,可確保在接合面以外之區域施加最小熱應力。
選擇性之單一焊球分配機制,且不需要掩蓋焊接位置的工具,因此可實現彈性靈活之焊接位置及無接觸式焊接。
特點
- 無需使用助焊劑(Fluxless)
- 無需使用掩蓋焊接位置的工具(Stencil or Mask)
- 無需清潔且無助焊劑殘留
- 高精準度置放功能
- 非接觸式焊接功能
- 低热應力之原位回焊
標準規範
應用
- BGA/PCB/cLCC 封裝植球
- BGA封裝之錫球做重工及修補
- 微機電(MEMS) & 高階封裝 (2D/3D/3.5D 封裝)
- 晶圓級封裝 (Wafer Bumping/ Wafer Level CSP Bumping)
- TSV-Via 焊料填補/ 焊料堆疊/ 密封製程
- 光學電子元件/ 微光學元件(Micro/Mini LED)
- 濾波器元件(SAW/ BAW)/ 相機模組/ 固態硬碟
規格
根據不同型號對應之規格不同。
LaPlace系列-雷射輔助2D/3D零件精密焊接設備
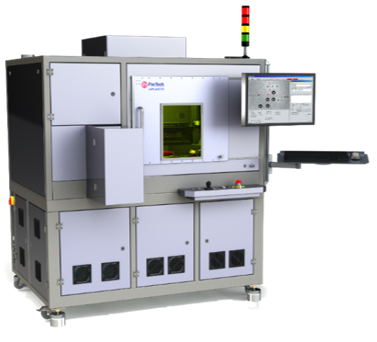
LaPlace系列設備是利用局部雷射束加熱功能,並可選擇性針對待焊接位置進行焊接,而無須將整個基材加熱到回焊溫度。
透過客製化治具與雷射束技術可同步進行置放與回焊,組裝與貼片精度高<5µm,其局部加熱功能適用於超大晶片、超小晶片貼片以及各類零件,可確保在完整回焊下同時預防基板和產品因過度受熱受壓所造成彎曲損害。
特點
- 無需使用助焊劑(Fluxless)
- 無需使用掩蓋焊接位置的工具(Stencil or Mask)
- 無需清潔且無助焊劑殘留
- 高精準度置放功能
- 非接觸式焊接功能
- 低热應力之原位回焊
標準規範
應用
- 高階封裝 (2D/3D/3.5D 封裝)
- 表面黏著技術 (SMT)
- 高精度覆晶放置/電子元件放置
- 探針卡組裝封裝
規格
根據不同型號對應之規格不同。







